日本filmetrics X板厚测量系统F3-s
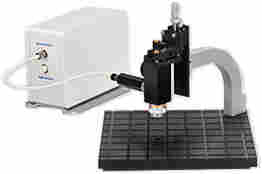
可以高精度测量硅基板和玻璃基板的厚度。
通过安装*初开发的具有高波长分辨率的分光镜,可以测量厚达 3 mm 的薄膜。
通过 10 μm 的小光斑直径,可以测量粗糙和不均匀的薄膜。
通过添加自动平台可以轻松测量面内分布。
高精度测量硅基板和玻璃基板的厚度
配备研发的高波长分辨率光谱仪!可测量* 3 mm 的厚膜
可以用 10 μm 的小光斑直径测量粗糙和不均匀的薄膜。
通过添加自动平台轻松测量面内分布
| 半导体 | 硅基板、LT基板、Ti基板等的厚度测量 |
|---|---|
| 平面显示器 | 玻璃基板厚度和气隙的测量 |
| 模型 | F3-s980 | F3-s1310 | F3-s1550 |
|---|---|---|---|
| 测量波长范围 | 960 – 1000nm | 1280 – 1340nm | 1520 – 1580nm |
膜厚测量范围 | 4 微米 – 350 微米 | 7 微米 – 1 毫米 | 10 微米 - 1.3 毫米 |
| 膜厚测量范围 (玻璃基板) | 10 微米 – 1 毫米 | 15 微米 - 2 毫米 | 25 微米 - 3 毫米 |
| 准确性 | ± 0.4% 薄膜厚度 | ||
| 测量光斑直径 | 10微米 | ||
*取决于样品和测量条件
随着半导体3D安装的进展,控制硅基板的厚度变得很重要。
F3-sX可以高精度、高速地测量硅基板的厚度。可以测量硅晶片上的氧化膜、抗蚀剂等。

硅基板厚度的测量