BGA测试仪为国内 X 射线技术研究和 X 射线智能检测装备研发的日联科技生产销售,日联科技是国内微聚焦X-RAY研发,x光安检机,工业探伤机,x-ray检测,车辆检测设备,x射线机的生产,销售为一体的高端检测设备高新技术企业.
BGA测试仪是利用阴极射线管产生高能量电子与金属靶撞击,在撞击过程中,因电子突然减速,其损失的动能会以X-Ray形式放出。而对于样品无法以外观方式检测的位置,利用纪录X-Ray穿透不同密度物质后其光强度的变化,产生的对比效果可形成影像即可显示出待测物之内部结构,进而可在不破坏待测物的情况下观察待测物内部有问题的区域。
金属材料及零部件、塑胶材料及零部件、电子元器件、电子组件、LED元件等内部的裂纹、异物的缺陷检测,BGA、线路板等内部位移的分析;判别空焊,虚焊等BGA焊接缺陷,微电子系统和胶封元件,电缆,装具,塑料件内部情况分析。
测试步骤:
确认样品类型/材料→样品放入X-Ray设备检测→图片判断分析→标注缺陷类型和位置。
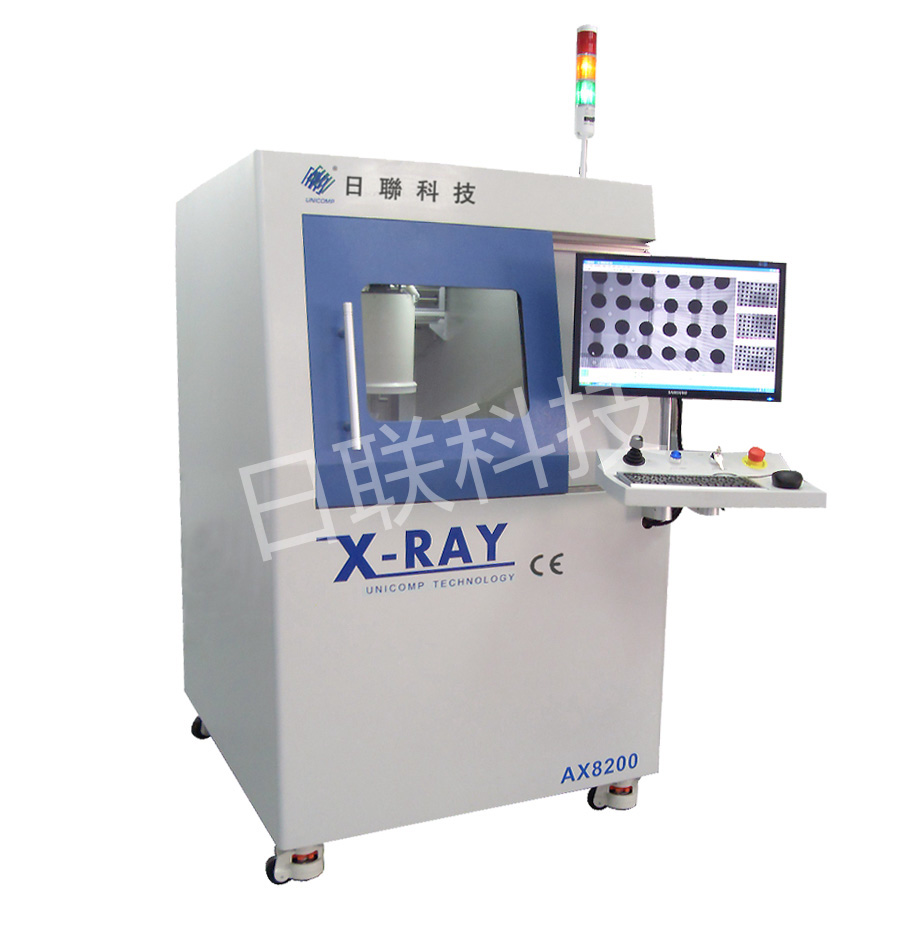
TBGA(载带型焊球数组)封装
TBGA(Tape Ball Grid Array) 是一种有腔体结构,TBGA 封装的芯片与基板互连方式有两种:倒装焊键合和引线键合。芯片倒装键合在多层布线柔性载带上;用作电路I/O 端的周边数组焊料球安装在柔性载带下面;它的厚密封盖板又是散热器(热沉),同时还起到加固封装体的作用,使柔性基片下面的焊料球具有较好的共面性。芯片粘结在芯腔的铜热沉上;芯片焊盘与多层布线柔性载带基片焊盘用键合引线实现互连;用密封剂将电路芯片、引线、柔性载带焊盘包封(灌封或涂敷)起来。 [3]
TBGA 的优点如下:
1、 封装体的柔性载带和 PCB 板的热匹配性能较好;
2、在回流焊过程中可利用焊球的自对准作用,印焊球的表面张力来达到焊球与焊盘的对准要求;
3、是经济的 BGA 封装;
4、 散热性能优于 PBGA 结构。
TBGA 的缺点如下:
1、对湿气敏感;
2、不同材料的多级组合对可靠性产生不利的影响。